您的位置:主页 > 公告动态 > 投资资讯 > 投资资讯
光刻手艺,有了新选择-外盘期货
光刻工艺是半导体器件制造工艺中的一个主要步骤,该步骤行使曝光和显影在光刻胶层上描绘几何图形结构,然后通过刻蚀工艺将光掩模上的图形转移到所在衬底上。
自1961年*台光刻机降生以来,光刻机履历了接触式→靠近式→投影式的生长蹊径,现在以投影式中的步进扫描式光刻机为主流。
在差其余阶段,每一代光刻机都遇到了亘古未有的挑战与难题,与此同时,光刻手艺也在这个历程中不停演进。
1、光刻手艺的生长路径,接触式光刻手艺
接触式光刻手艺泛起于20世纪60年月,是小规模集成电路时期最主要的光刻手艺,有着良率低、成本高的特点。

接触式光刻示意图
接触式光刻手艺中掩膜版与晶圆外面的光刻胶直接接触,一次曝光整个衬底,掩膜疆土形与晶圆图形的尺寸关系是1:1,分辨率可达亚微米级。接触式可以减小光的衍射效应,但在接触历程中晶圆与掩膜版之间的摩擦容易形成划痕,发生颗粒沾污,降低了晶圆良率及掩膜版的使用寿命,需要经常替换掩膜版,故靠近式光刻手艺得以引入。
靠近式光刻手艺
靠近式光刻手艺普遍应用于20世纪70年月,靠近式光刻手艺中的掩膜版与晶圆解释光刻胶并未直接接触,留有被氮气填充的间隙。
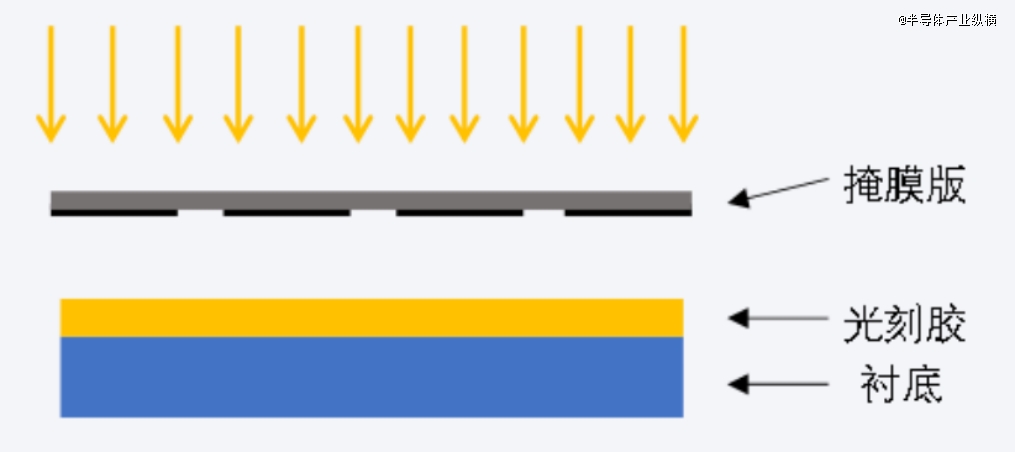
靠近式光刻示意图
靠近式光刻手艺的特点是最小分辨尺寸与间隙成正比,间隙越小,分辨率越高。瑕玷是掩膜版和晶圆之间的间距会导致光发生衍射效应,因此靠近式光刻机的空间分辨率极限约为2u m。随着特征尺寸缩小,泛起了投影光刻手艺。
投影式光刻手艺
20世纪70年月中后期泛起投影光刻手艺,可以有用提高分辨率。
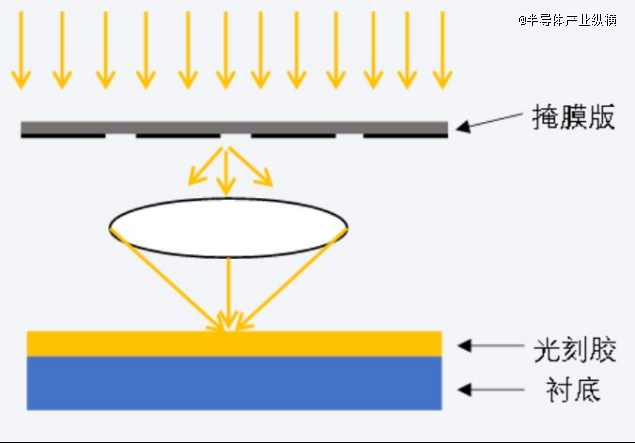
投影式光刻示意图
基于远场傅里叶光学成像原理,在掩膜版和光刻胶之间接纳了具有缩小倍率的投影成像物镜。早期掩膜版与衬底图形尺寸比为1:1,随着集成电路尺寸的不停缩小,泛起了缩小倍率的步进重复光刻手艺。
步进重复光刻手艺
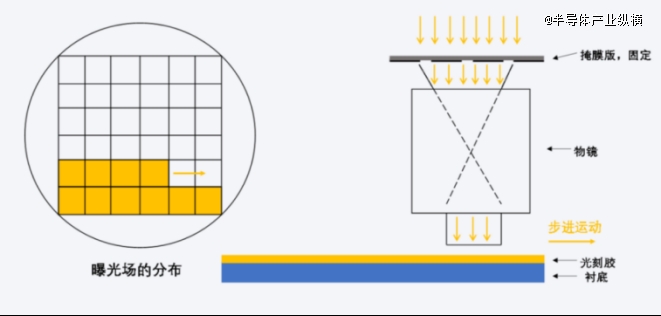
步进重复光刻示意图
步进重复光刻主要应用于0.25微米以上工艺,光刻时掩膜版牢靠不动,晶圆步进运动,完成所有曝光事情。随着集成电路的集成度不停提高,芯片面积变大,要求一次曝光的面积增大,促使更为先进的步进扫描光刻机问世。
步进扫描式光刻机
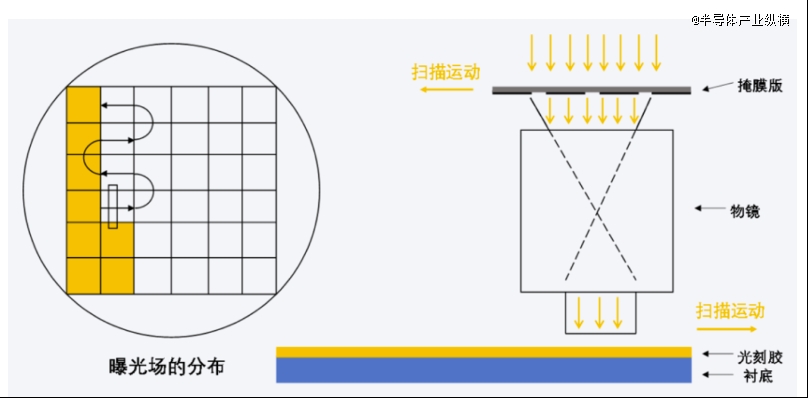
步进扫描光刻示意图
当制程工艺生长到0.25微米后,步进扫描式光刻机的扫描曝光视场尺寸与曝光平均性更具优势,逐步成为主流光刻装备(DUV和EUV)。其行使 26mm x 8mm 的狭缝,接纳动态扫描的方式(掩模版与晶圆片同步运动),可以实现 26mm x 33mm 的曝光场。当前曝光场扫描完毕后,转移至下一曝光场,直至整个晶圆曝光完毕。
自1990年SVGL公司推出Micrascan I步进扫描光刻机以来,光刻机产业就进入了DUV时代,通过多重曝光等手艺手段,一直到7nm芯片量产,DUV都是市场的统治者。
然而随着制程演进到5nm,DUV和多重曝光手艺的组合也难以知足量产需求了,EUV光刻机就成为前道工序的必须品。之后制程节点不停演进,行业对EUV光刻机的要求越来越高,对其生长远景和生长路径也提出了更多期待。
对于未来光刻手艺的生长,业界正起劲寻找高精度且经济的方式,以在晶圆上天生图案。多家公司/研究机构已宣布了其研究希望,一起来看看他们为光刻手艺带来了哪些新的选择。
2、选择之一:High NA EUV光刻机
光刻机所使用的光源波长从最早的紫外光源(ultraviolet, UV),如g线(波长436 nm)、i线(波长365 nm)光源,生长到以KrF(波长248 nm)、ArF(波长193 nm)为代表的深紫外光源(deep ultraviolet, DUV),再到现在波长13.5 nm的极紫外光源(extreme ultraviolet, EUV)。
随着光源波长的不停缩短,光刻机单次曝光分辨率不停提升,现在*进的EUV光刻机曝光分辨率为13纳米,可用于3 nm制程芯片的生产。
现在,台积电、三星、英特尔等芯片制造公司之间的竞争已进入先进制程赛道。在此历程中,EUV极紫外光刻装备也已经成为各厂商争取的焦点。
据悉,2024-2025年,台积电将接受60台EUV光刻机,预估总用度将超122亿美元;英特尔率先拥抱全球*台High NA EUV光刻机;三星也在向High NA EUV光刻机跃跃欲试,试图追赶台积电。
然而追逐*进的光刻机的同时,是喜悦的也是痛苦的。
喜悦在于,*获得*进的光刻机意味着可以极大地提升其芯片制造能力和效率,辅助公司在未来先进制程手艺的竞争中取得先行优势。
痛苦在于,EUV高昂的售价令各大芯片厂商苦不堪言。据悉,现在0.33NA EUV光刻机的售价约为1.81亿美元每台,新一代的High-NA(0.55NA)EUV倍增至2.9-3.62亿美元一台。而进入1纳米以下的埃米世代后,ASML将设计推出更先进Hyper-NA(0.75NA)EUV光刻机装备,其售价则有可能跨越7.24亿美元。
这一方式显然足够细腻但不够经济。因此业内也有不少机构正在探讨High NA EUV的降本之法,他们将主要精神放在了提升光源分辨率上。
ASML当前所接纳的激光等离子体EUV光源(EUV-LPP)价钱昂贵,效率低下,光电转化率仅为3%-5%。要提升功率,有几条生长路径可供选择:有人行使传统的LPP光源系统,在已有基础上,不停增添功率;另有人接纳分时高功率光纤激光器射击液态锡靶手艺,用这种方式制造的光源,其光源功率有望跨越传统LPP数倍。
使用能量接纳型直线加速器(ERL)的FEL(自由电子激光)方案也是一种设施。日本高能加速器研究组织(KEK)的研究职员以为,若是行使粒子加速器的气力,EUV光源的获取可能会更廉价、更快、更高效。
FEL行使电子在磁场中的运动发生*激光,其效率比通俗EUV光源凌驾一倍,能量转化率跨越30%,且拥有成本低、功率大等优势。在电力消耗方面,FEL光源也要远低于EUV-LPP光源。此外,EUV-FEL还可升级为BEUV-FEL,以使用更短的波长(6.6-6.7 nm)实现更细腻的图案化。它还可以可变地控制FEL光的偏振,以实现High NA光刻。
关于西安市工业倍增基金拟出资项目的公示
据悉,现在业界已经设计了一种基于能量接纳直线加速器(ERL)的FEL光源用于未来的光刻,而且已经研究和开发了主要组件。FEL光源在EUV功率、升级到BEUV-FEL、High NA光刻的偏振控制、电力消耗和每台光刻机的成本方面具有许多优势。
EUV-FEL光源也被以为是未来光刻最有前途的光源。
不外,对于光刻手艺的未来生长,业内另有不少人持有差异看法。
3、选择之二:纳米压印手艺(NIL)
纳米压印和光刻手艺的“较量”由来已久。
纳米压印是基于高分子模压手艺的微纳加工手艺。纳米压印需要一个模板,就像活字印刷的模板上刻着要印的字,纳米压印的模板上是需要制造的纳米结构,然后通过加热加压,把模板上的纳米结构复制到纳米压印的质料里。
形象一点可以将其类比为活字印刷术。

与光刻手艺相比,纳米压印手艺具有以下优势:
成本更低:相比光刻手艺,纳米压印手艺的成本更低,主要缘故原由是纳米压印装备相对廉价且工序简朴,更易于批量操作。
精度更高:通过全心设计和制造高精度的“印章”,纳米压印手艺可以实现优于10nm的高精度电路图印制,为芯片制造提供更高的精度保障。
更普遍的应用领域:纳米压印手艺不仅适用于逻辑芯片和存储芯片的制造,还可以普遍应用于DOE、AR/VR衍射光波导、生物芯片、LED等领域的量产,具有较大的市场潜力。
现在纳米压印在LED、AR、VR等领域被普遍运用。纳米压印已生长二十余年,但在相当长一段时间里,由于纳米压印的制制品缺陷多、良率低,不太被半导体领域接受,光刻手艺则生长得更快、更好。
而在近十年,随着纳米压印对工艺的优化和控制精度上了一个台阶,一度被光刻否认的纳米压印,迎来了高光时刻。
不外纳米压印手艺也有它的短板,它是一种物理接触式的加工手艺。在物理接触的历程中,容易发生一些外部缺陷。而半导体行业对缺陷的容忍度异常低。业界有一部门人以为纳米压印是异常有远景的手艺,另有一部门人以为它的缺陷率对照高,不适合半导体加工。
佳能公司在传统的光刻领域落伍于ASML公司之后,一直在半导体制造偏向寻找新的突破点,它的探讨重点之一就是纳米压印手艺。
去年10月中旬,佳能宣布推出FPA-1200NZ2C纳米压印半导体制造装备,可制造5nm芯片。据佳能公司CEO透露,装备售价将“比ASML的EUV光刻机少一位数”。
璞璘科技首创人葛海雄去年年底曾示意:从最近的报道来看,佳能公司的纳米压印各项手艺指标已经与DUV的光刻手艺持平,有一些指标甚至到达了EUV的光刻手艺。
关于纳米压印手艺的未来,葛海雄示意,依据佳能提供的手艺参数、指标,纳米压印有可能为半导体领域缔造一些有益的弥补,由于ASML、尼康的半导体光刻装备已经在产线上被普遍接纳了,纳米压印可以看成是光刻手艺的衍生。
因此,纳米压印手艺也被称为未来半导体制造的焦点手艺。
现在,不少科研机构和厂商都加大了纳米压印上的投入。除了佳能,外洋厂商如EV Group、Nanonex Corp、Obducat AB、SUSS MicroTec等公司已生产纳米压印光刻装备。海内也有不少厂商在纳米压印赛道上加紧结构,如青岛天仁微纳、苏州苏大维格、歌尔股份、苏州光舵微纳、升印光电、新维度微纳、埃眸科技等。
获得华为哈勃青睐的海内头部厂商天仁微纳现在产物涵盖整机装备、模具、压印质料,研发了多款高精度紫外纳米压印装备,已经实现*150/300mm基底面积上高精度(优于10nm )、高深宽比(优于10比1)纳米结构复制量产。
对于纳米压印手艺*落地的领域,或许是存储芯片。
在芯片制造领域,现在最契合纳米压印手艺的,就是存储芯片,尤其是3D NAND、DRAM等存储芯片。从佳能设计的纳米压印装备蹊径图来看,纳米压印应用将从3D NAND存储芯片最先,逐渐过渡到DRAM,最终实现CPU等逻辑芯片的制造。
存储厂商在芯片制造上对成本把控极为严苛,同时设计的余量可以遭受一定的缺陷而不影响制品率,放宽对缺陷的要求,以是现在已经有不少存储厂商设计使用纳米压印手艺来制造存储芯片。
铠侠、东芝等日系存储厂商很早便最先结构纳米压印手艺。今年3月,美光公司宣布设计率先支持佳能的纳米印刷手艺,从而进一步降低生产DRAM存储芯片的单层成本。此前,内存大厂SK海力士也引入了佳能纳米压印机,用于举行3D NAND的生产测试。
纳米压印手艺与存储芯片相连系,将大大提高存储厂商的生产效率,并降低成本。纳米压印装备在芯片制造领域大规模商用化后,其优势将加倍显著。
因此纳米压印手艺也被称为最有时机取代现有光刻手艺的手艺手段。
4、选择之三:电子束光刻(EBL&MEBL)手艺
说到电子束光刻手艺,在这里要再提及一下光刻手艺的原理。
众所周知,光刻是整个微加工工艺中手艺难度*,也是最为要害的手艺步骤。所谓光刻就是通过对光束举行控制,在一层薄薄的光刻胶外面“刻蚀”出我们需要的图案,光束照过的位置光刻胶的化学性子会发生转变,通过显影液的浸泡会使照射过的部门去除(正胶)或者保留(负胶)。
光源的波长是影响光刻精度的主要缘故原由,由于光源波长的限制,X射线曝光可到达50nm左右的精度,深紫外光源的曝光精度在100nm左右,而电子的波长较小,因而电子束光刻的加工精度可以到达10nm以内。
电子束光刻以其分辨率高、性能稳固,成真相对较低的特点,因而成为人们最为关注的下一代光刻手艺之一。
电子束光刻根据曝光方式划分可分为两种,投影式曝光与直写式曝光。投影式曝光通过控制电子束照射掩模图形,将掩模图形投影至光刻胶外面,把掩模板上的图案转移到光刻胶上,原理类似于照相机,拍摄工具好比掩模板,光刻胶就像是胶卷,通过光线的照射把拍摄工具投影到胶卷上。
直写式光刻不需要掩模版,通过磁场直接控制电子束斑根据预设的轨迹在光刻胶外面照射,完成图案转移,就像是画画,铅笔类似于电子束,纸类似于光刻胶,而我们的手类似于磁场,通过手控制铅笔的移动完成图画的绘制。
由于基于掩膜的传统光刻手艺,其成本正呈指数级攀升。无掩膜的电子束光刻手艺则提供了弥补性选项,由于不需要昂贵的光掩模,直写手艺很有吸引力。但单光束电子束光刻的吞吐量太慢,对于批量 IC 生产来说成本太高。剖析人士也直言,直写真正的问题是吞吐量。直接写入光刻手艺,纵然有数十万甚至一百万个光束,但对于晶圆光刻来说也太慢了。
因此,单光束直写工具只能用于复合半导体和光子学等小众应用。
为领会决写入慢的难题,Multibeam给出了它的谜底。
克日,电子束光刻手艺的主要介入者Multibeam推出了 MB Platform,——全球首创的多柱电子束光刻 (MEBL:Multicolumn E-Beam Lithography )。据先容,其新光刻系统是专为大规模生产而打造的系统。全自动周详图案化手艺将用于快速成型、先进封装、高夹杂生产、芯片 ID、复合半导体和其他应用。Multibeam示意,公司刚宣布的平台将以新的生产力优势彻底改变了电子束光刻,同时实现了高分辨率、细腻特征、宽视野和大景深。
Multibeam 首席执行官兼董事长 David K. Lam 在接受采访时示意,Multibeam 可以使芯片制造的某些部门的生产效率比现有系统凌驾 100 倍。
在Multibeam 看来,这是一款改变了游戏规则的装备。不外,早在80年月,那时人们普遍以为光学曝光已经走到了终点,电子束光刻是最有远景的替换手段,然而,30多年已往了,电子束光刻依然无法替换光学曝光。在两种光刻手艺的生长方面逐渐形成了相互弥补的名目。
随着科技的日新月异,新型光刻手艺的涌现无疑为行业注入了新的活力。未来,这些创新的光刻手艺将给半导体行业带来哪些惊喜,我们拭目以待!
